AuRoFUSE™ von TANAKA: Bonding-Technologie zur dichten Montage von Halbleitern
24.04.2024 / ID: 410838
Elektro & Elektronik
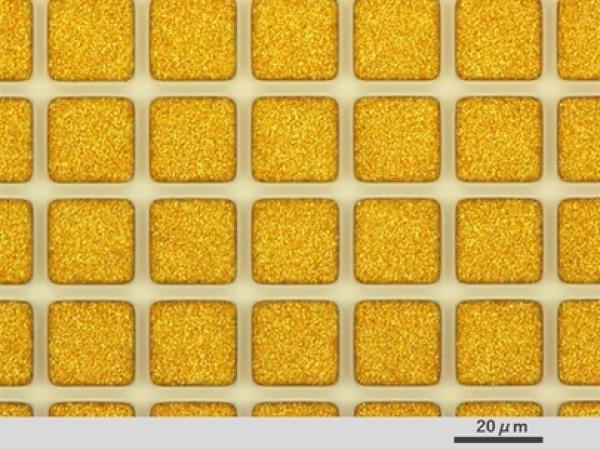 AuRoFUSE™ von TANAKA ist ein neuer Werkstoff zum Bonding von Goldkontakten. Durch seine einzigartige poröse Struktur aus Goldpartikeln eignet es sich für das dicht gepackte Kontaktieren von sehr kleinen Komponenten in der Mikroelektronik. Mit AuRoFUSE™ lassen sich bei relativ niedrigen Temperaturen feinste Kontakte mit niedrigem elektrischem Widerstand und hoher thermischer Leitfähigkeit herstellen.
AuRoFUSE™ von TANAKA ist ein neuer Werkstoff zum Bonding von Goldkontakten. Durch seine einzigartige poröse Struktur aus Goldpartikeln eignet es sich für das dicht gepackte Kontaktieren von sehr kleinen Komponenten in der Mikroelektronik. Mit AuRoFUSE™ lassen sich bei relativ niedrigen Temperaturen feinste Kontakte mit niedrigem elektrischem Widerstand und hoher thermischer Leitfähigkeit herstellen.Mit AuRoFUSE™ hat TANAKA auch einen neuen Bonding-Prozess entwickelt (AuRoFUSE™-Präformen). Dabei wird die AuRoFUSE™-Paste vor der Anwendung getrocknet, dadurch lassen sich feste Präformen erzeugen mit 20 Mikrometer breiten Kontakthöckern in einem Abstand von nur vier Mikrometern. Beim Bonden etwa eines Mikrochips werden dessen Kontakte auf die Kontakthöcker dieser Präform gedrückt, wodurch sich eine feste und chemisch stabile Verbindung hoher Leitfähigkeit ergibt. Dabei verformt sich das poröse Material bis zu zehn Prozent in Richtung der vertikalen Kraft, in horizontaler Richtung deformiert es sich dagegen kaum. Es gibt daher kein "Zerfließen" wie bei gelöteten Kontakten und damit auch nicht die Gefahr, dass sich Kontakte berühren und kurzschließen.
Die neue Technologie ermöglicht eine höhere Integrationsdichte und damit eine weitere Miniaturisierung der Kontaktierung von Mikrochips. Von AuRoFUSE™ werden viele Technologien profitieren wie Leuchtdioden und Halbleiterlaser sowie alle Arten von digitalen Geräten wie Personalcomputer, Smartphones, Fahrzeuge und viele mehr.
TANAKA stellte die AuRoFUSE™-Technologie auf der 38. Frühjahrskonferenz des Japan Institute of Electronics Packaging vor, die vom 13. bis 15. März 2024 an der Tokyo University of Science stattgefunden hat. Danach beginnt TANAKA mit der Verteilung von Mustern an seine Kunden.
Herstellung von AuRoFUSE™ Präformen
(1) Metallisierung mit Gold/Platin/Titan erzeugt die Basisschicht auf dem Trägermaterial
(2) Aufbringen eines lichtempfindlichen Fotolacks
(3) Erzeugen des Präform-Musters durch Belichten und Entwickeln des Fotolacks
(4) AuRoFUSE™ fließt in das Gitter
(5) Trocknen im Vakuum bei Raumtemperatur, danach Abziehen von überschüssigem Gold
(6) Sintern durch Aufheizen, danach Entfernen des Gitters aus Fotolack
Hochdichte Chipmontage mit AuRoFUSE™ Präformen
Je nach Anwendungszweck werden für die Montage von Halbleiterbauelementen verschiedene Bondverfahren verwendet, darunter Löt- und Plattierungsverfahren. Die Bondmethode mit Lötzinn ist kostengünstig und schnell. Allerdings neigt Lötzinn dazu, sich beim Schmelzen nach außen auszubreiten. Das kann zu Kurzschlüssen führen, wenn in Folge weiterer Miniaturisierung die Kontakthöcker nahe beieinanderliegen. Eine Alternative für die High-Density-Montage ist die stromlose Beschichtung für die Herstellung von Kontakthöckern aus Kupfer und Gold. Damit lassen sich sehr geringe Abstände erreichen, allerdings sind beim Bonden höhere Drücke erforderlich. Es gibt daher Bedenken wegen möglicher Schäden an Chips.
Die ideale Bonding-Methode kommt mit niedrigen Temperaturen und Drücken aus. Genau das ist nun mit AuRoFUSE™ von TANAKA möglich. Ein weiterer Vorteil gerade beim Bonding von sehr kleinen Chips ist, dass das Material durch seine Porosität Unebenheiten auf der Oberfläche der Kontakte ausgleicht. Frühere Versuche mit weichen Pasten führten nicht zum gewünschten Ergebnis. Stattdessen setzen die Forscher von TANAKA auf eine Paste, die vor dem Bonden getrocknet wird, um das Fließen und Kurzschlüsse zu verhindern. Durch seine poröse Struktur ist das Material dennoch gut formbar und passt sich Höhendifferenzen der Elektroden oder des Substrats an.
Über AuRoFUSE™
AuRoFUSE™ ist ein pastenartiges Bindematerial aus Goldpartikeln kleiner als ein Mikrometer sowie einem organischen Lösungsmittel. Mikroskopisch kleine Partikel sintern, das heißt sie verbinden sich miteinander, wenn sie auf eine Temperatur unterhalb des Schmelzpunktes erhitzt werden. So auch bei AuRoFUSE™: Wird es auf 200°C erhitzt, verdampft das Lösungsmittel und die Goldpartikel gehen ohne Druck eine Sinterbindung ein mit einer ausreichenden Bindungsstärke von etwa 30 MPa.
(Die Bildrechte liegen bei dem Verfasser der Mitteilung.)
Firmenkontakt:
TANAKA Holdings Co., Ltd.
Tokyo Building 22F, 7-3, Marunouchi 2-chome, Chiyoda-ku
100-6422 Tokyo
Deutschland
+49 160 1220366
https://tanaka-preciousmetals.com/de/
Pressekontakt:
Storymaker GmbH
Schwanthalerstraße 73
80336 München
+49 160 1220366
http://www.storymaker.de
Diese Pressemitteilung wurde über PR-Gateway veröffentlicht.
Für den Inhalt der Pressemeldung/News ist allein der Verfasser verantwortlich. Newsfenster.de distanziert sich ausdrücklich von den Inhalten Dritter und macht sich diese nicht zu eigen.
Empfehlung | devASpr.de
Kostenlos Artikel auf newsfenster.de veröffentlichen
Kostenlos Artikel auf newsfenster.de veröffentlichen
Weitere Artikel von TANAKA Holdings Co., Ltd.
21.03.2025 | TANAKA Holdings Co., Ltd.
TANAKA entwickelt miniaturisiertes Mikroprofil-Kontaktband für Signalrelais der fünften Generation
TANAKA entwickelt miniaturisiertes Mikroprofil-Kontaktband für Signalrelais der fünften Generation
27.01.2025 | TANAKA Holdings Co., Ltd.
TANAKA entwickelt AgSn TLP-Folie, ein neues Verbindungsmaterial für Leistungshalbleiter
TANAKA entwickelt AgSn TLP-Folie, ein neues Verbindungsmaterial für Leistungshalbleiter
05.06.2024 | TANAKA Holdings Co., Ltd.
TANAKA Precious Metals stellt auf der PCIM Europe 2024 aus
TANAKA Precious Metals stellt auf der PCIM Europe 2024 aus
09.11.2023 | TANAKA Holdings Co., Ltd.
TANAKA entwickelt erstes Hochentropie-Legierungspulver ausschließlich aus Edelmetallen
TANAKA entwickelt erstes Hochentropie-Legierungspulver ausschließlich aus Edelmetallen
16.05.2023 | TANAKA Holdings Co., Ltd.
TANAKA stellt Legierung TK-FS für Prüf-Pins vor
TANAKA stellt Legierung TK-FS für Prüf-Pins vor
Weitere Artikel in dieser Kategorie
20.04.2026 | PEARL GmbH
tka Köbele Akkutechnik 4er-Set Li-Ion-Akkus AA/AAA,wiederaufladbar
tka Köbele Akkutechnik 4er-Set Li-Ion-Akkus AA/AAA,wiederaufladbar
16.04.2026 | IDCRAFT GmbH
IDCRAFT 3DTag - 3D-gedruckte RFID Transponder / Tags für individuelle Industrieanwendungen
IDCRAFT 3DTag - 3D-gedruckte RFID Transponder / Tags für individuelle Industrieanwendungen
13.04.2026 | Sparkoz Technology Corporation
Sparkoz stellt auf der Interclean Amsterdam 2026 zwei Flaggschiff-Modelle für die gewerbliche Reinigung vor
Sparkoz stellt auf der Interclean Amsterdam 2026 zwei Flaggschiff-Modelle für die gewerbliche Reinigung vor
09.04.2026 | Carmen Kassing Texte @ Übersetzungen
NH/HH-Recyclingverein veröffentlicht Jahresbericht 2025
NH/HH-Recyclingverein veröffentlicht Jahresbericht 2025
31.03.2026 | digitalsignage.de
Digitale Türschilder für Outlook, Exchange, Google und Notes von digitalSIGNAGE.de
Digitale Türschilder für Outlook, Exchange, Google und Notes von digitalSIGNAGE.de

